成功案例
混裝BGA焊點開裂不良失效分析
- 分類:失效分析案例
- 作者:
- 來源:混裝BGA焊點開裂不良失效分析
- 發布時間:2024-12-09 16:59:32
- 訪問量:0
混裝BGA焊點開裂不良失效分析
詳情
針對某混裝工藝的PCBA上BGA器件發生功能不良,本案例通過CT掃描、切片分析初步確定造成器件功能不良的原因主要為BGA焊點開裂。
1. 案例背景
送檢樣品為某款PCBA板,上面BGA封裝的CPU發生功能失效,初步懷疑為焊接問題導致。該BGA焊點使用錫膏為有鉛錫膏,BGA值球為無鉛,PCB焊盤為ENIG工藝。
2. 分析方法簡述
通過對器件焊點進行切片分析,如圖2所示,BGA焊點在焊盤端和器件端均存在開裂現象,但大部分焊點開裂主要發生在器件端界面。
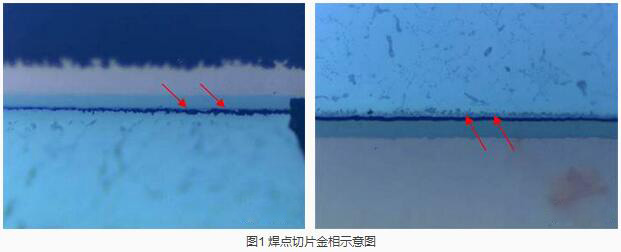

3. 結果與討論
由上述測試分析可知,導致失效樣品失效的直接原因為CPU上四周焊點發生開裂,而焊點開裂的原因與兩方面相關:(1)焊點上界面存在較多Pb偏析和錫金合金,致使界面機械性能弱化;(2)部分焊點下界面存在富P層偏厚現象,致使界面機械性能弱化(3)樣品在后續裝配過程中,受較大機械應力。
混裝工藝中,由于為無鉛和有鉛焊料混合封裝,Pb偏析和界面的錫金合金在中不可避免,可通過焊接工藝曲線的控制來減少Pb偏析,界面的錫金合金過多與芯片端焊盤的金層過厚相關,后續可重點減小裝配時的機械應力,并適當的優化工藝曲線來避免失效的發生。
上一個:
PCBA銅孔撕裂失效分析
下一個:
電感的失效分析
上一個:
PCBA銅孔撕裂失效分析
下一個:
電感的失效分析
Copyright? 2021 蘇州天標檢測技術有限公司 版權所有 蘇ICP備15049334號-3




.jpg)
